|
自博通(Broadcom)官网获悉,博通公司晓谕推出其3.5D eXtreme Dimension系统级(XDSiP)封装平台本事。这是业界首个3.5D F2F封装本事,在单一封装中集成跳跃6000mm²的硅芯片和多达12个HBM内存堆栈,以知足AI芯片的高放荡、低功耗的计较需求。 本文援用地址: 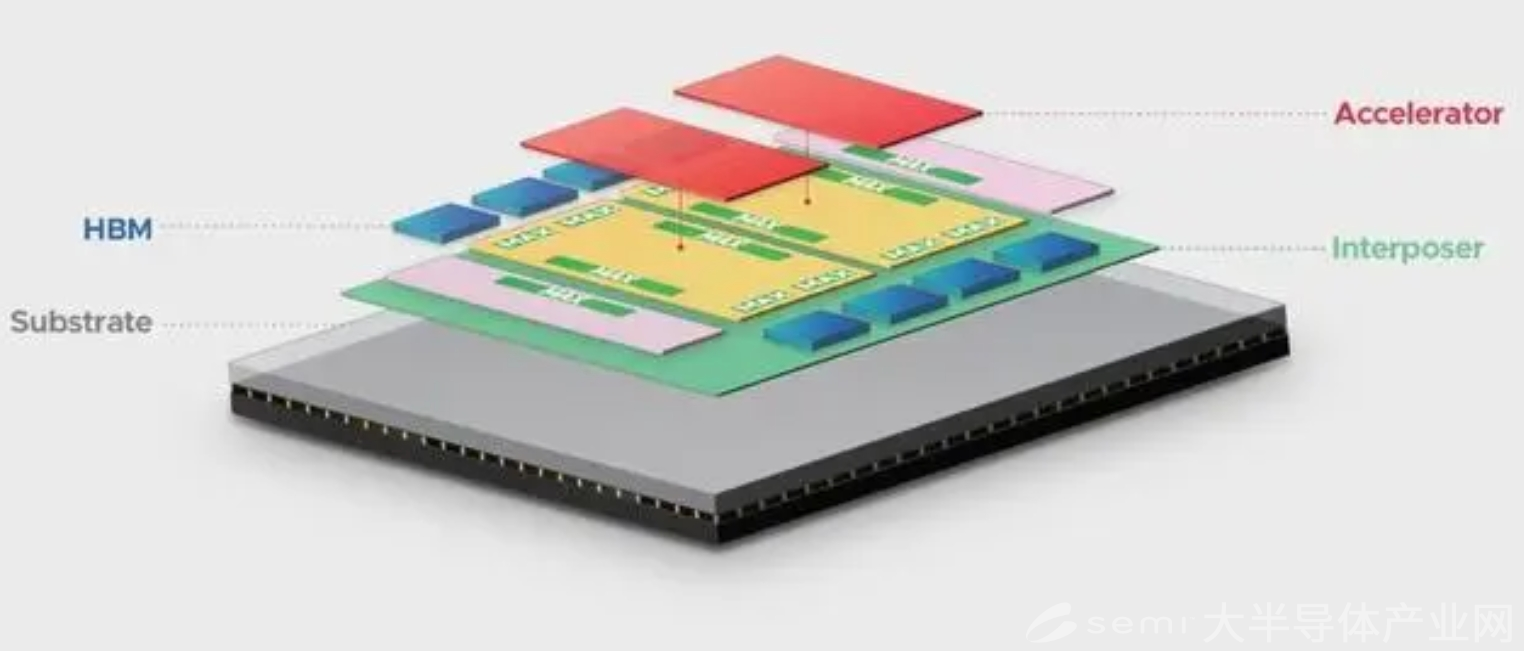 据先容,博通]article_adlist--> 据先容,博通]article_adlist-->的3.5DXDSiP平台在互联密度和功率放荡方面较F2B方式终赫然权贵提高。这种立异的F2F堆叠神色径直相接顶层金属层,从而终赫然密集可靠的相接,并最小化电气插手,具有极佳的机械强度。博通的3.5D平台包括用于高效终了3D芯片堆叠的电源、时钟和信号互联的IP和独有筹划经由。 Broadcom 3.5D XDSiP的关节上风 增强的互联密度:在堆叠的芯片之间终赫然比F2B本事高7倍的信号密度。 更高的功率放荡:通过使用3D HCB而不是平面的芯片间PHY,将芯片盘曲口的功耗镌汰了10倍。 镌汰蔓延:在3D堆叠中,最小化了计较、内存和I/O组件之间的蔓延。 紧凑的封装尺寸:使互连器和封装尺寸更小,从而不详老本并改善封装翘曲。 博通起始的F2F 3.5D XPU集成了四个计较芯片、一个I/O芯片和六个HBM模块,诈欺台积电先进的工艺节点和2.5D CoWoS®封装本事。博通基于行业圭臬器具的独有筹划经由和自动化方式学确保了芯片的初次告捷竞猜大厅,尽管其极为复杂。3.5D XDSiP已在关节IP块(包括高速SerDes、HBM内存接口和芯片间互连)上展示了竣工的功能和出色的性能。这一设置突显了博通在筹划和测试复杂3.5D集成电路方面的专科手段。 声明:新浪网独家稿件,未经授权辞让转载。 --> |

